在当今社会中,制造商总是在寻找那些更低能耗和更高效率的设备。来自IMS研究所的Barry Young对此做了统计,预计2010年全球发光二极管(
LED)的需求将增长61%,手机市场是很大的触发因素。大面积的背光
LED电视市场正在迅速扩大,LED也被广泛应用于
投影仪、手电筒、汽车尾灯和头灯、普通照明等市场。固态白光源可以通过混合红光、绿光、
蓝光LED来实现,或者通过使用磷光材料将单色
蓝光或紫外LED转换成宽光谱的白光。
随着LED产量的增加,LED制造商正在寻找可以优化划片宽度、划片速度与加工产量的新工艺进展。新型LED激光剥离(LLO)和激光晶圆划片设备给LED制造商提供了高性价比的工业工具,可以满足日益增长的市场需求。
高亮度垂直结构LED
通常情况下,蓝光/绿光LED是由几微米厚的氮化镓(GaN)薄膜在蓝宝石衬底上外延生长形成的。 一些LED的制造成本主要取决于蓝宝石衬底本身的成本和划片—裂片加工成本。对于传统的LED倒装横向结构,蓝宝石是不会被剥离的,因此,阴极和阳极都在同一侧的氮化镓外延层(epi)(图1)。
.jpg)
图1. 传统的横向结构的蓝光LED。 MQW =多量子阱。
这种横向结构对于高亮度LED有几个缺点:材料内电流密度大、电流拥挤、可靠性较差、寿命较短;此外,通过蓝宝石的光损很大。
设计人员通过激光剥离(LLO)工艺可以实现垂直结构的LED,它克服了传统的横向结构的各种缺陷。垂直结构LED可以提供更大的电流,消除电流拥挤问题以及器件内的瓶颈问题,显著提高LED的最大输出光功率与最大效率(图2)。
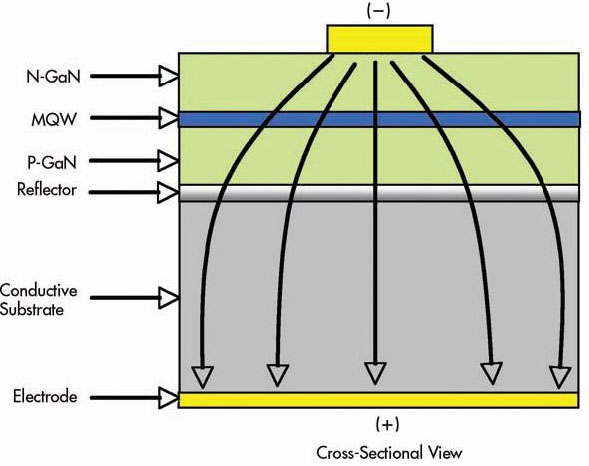
图2.垂直结构的蓝光LED
垂直LED结构要求在加电极之前剥离掉蓝宝石。准分子激光器已被证明是分离蓝宝石与氮化镓薄膜的有效工具。LED激光剥离技术大大减少了LED加工时间,降低了生产成本,使制造商在蓝宝石晶圆上生长氮化镓LED薄膜器件,并使薄膜器件与热沉进行电互连。这个工艺使得氮化镓薄膜可以独立于支撑物,并且氮化镓LED可以集成到任何基板上。
激光剥离原理
紫外激光剥离的基本原理是利用外延层材料与蓝宝石材料对于紫外激光具有不同的吸收效率。蓝宝石具有较高的带隙能量(9.9 eV),所以蓝宝石对于248nm的氟化氪(KrF)准分子激光(5 eV辐射能量)是透明的,而氮化镓(约3.3 eV的带隙能量)则会强烈吸收248nm激光的能量。正如图3所示,激光穿过蓝宝石到达氮化镓缓冲层,在氮化镓与蓝宝石的接触面进行激光剥离。这将产生一个局部的爆炸冲击波,使得在该处的氮化镓与蓝宝石分离。基于同样的原理,193nm的氟化氩(ArF)准分子激光可以用于分离氮化铝(AlN)与蓝宝石。具有6.3 eV带隙能量的氮化铝可以吸收6.4 eV的ArF激光辐射,而9.9 eV带隙能量的蓝宝石对于ArF准分子激光则是透明的。
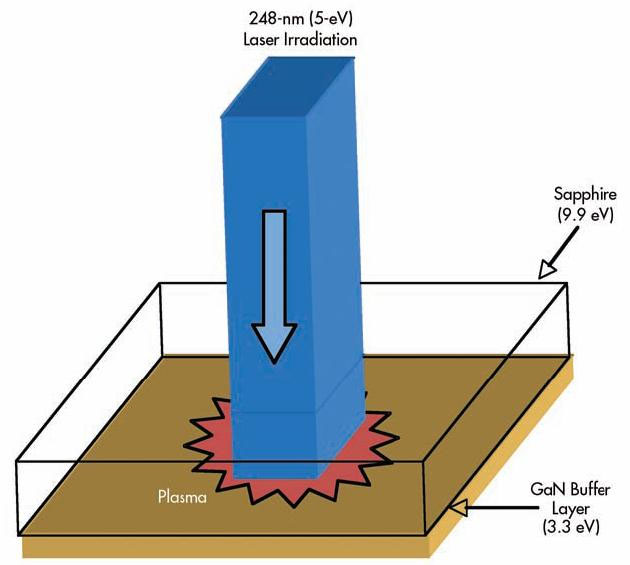
图3. 248nm激光剥离示意图
光束均匀性和晶圆制备对于实现成功剥离都很重要。JPSA公司采用创新的光束均匀化专利技术使得准分子激光束在晶圆上可以产生最大面积达5 × 5毫米的均匀能量密度分布的平顶光束。
正确的晶圆制备是LLO成功的关键。需要最大限度地减少在蓝宝石上高温外延层生长过程中产生的残余应力,还要保证外延层和衬底进行充分键合,以避免在剥离过程中外延片破裂。图4展示了一个典型的剥离效果。

图4. 248nm激光脉冲对蓝宝石上的氮化镓进行激光剥离(一个脉冲激光光斑一次覆盖9个芯片)。
LLO系统可以在室温环境下进行高速、高产量的加工。精心设计的系统允许单发脉冲光斑同时覆盖多个芯片,并采用“飞行射击”革新技术使得每一发脉冲光斑都能与晶圆芯片定位精确对准。
蓝光LED晶圆激光划片
传统的制造商仍在继续供应横向结构的蓝光LED,激光划片是加工这种结构的晶圆的理想选择。蓝宝石的极高硬度给锯片切割与金刚石划片带来芯片成品率低、产量低和成本高等诸多问题。
与传统的钻石划片方式相比,紫外(UV)二极管泵浦固体(DPSS)激光划片方式的芯片成品率和晶圆产量大幅增加,并且LED晶圆的亮度没有明显损耗。短波长激光在氮化镓和蓝宝石层的吸收率都增加了,这样可以降低划片所需的辐射光功率,同时减小了切口宽度。
划片宽度、速度和加工产量是保持低加工成本与晶圆高产量的主要参数。JPSA已开发出一种专利的光束传输系统,该系统可以获得很狭窄的2.5微米切口宽度(图5),并提供特有的表面保护液以尽量减少碎片。在聚焦的激光束下方移动晶圆进行一次非常狭窄的V形切割,从外延面开始扩展到蓝宝石层,通常划片深度为20到30微米。激光划片之后,用标准的裂片机在V形激光切缝处集中应力进行裂片加工。
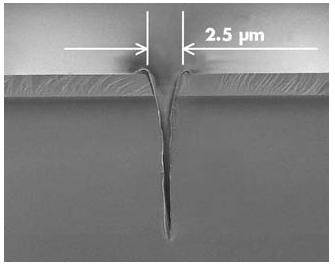
图5. 氮化镓-蓝宝石晶圆激光划片的切口宽度2.5微米。
266nm激光正切划片的切口宽度越窄,每片晶圆生产的可用芯片数目就越多,从而可以增加加工总产量。
可以用普通的2英寸直径、250 × 250微米芯片的蓝光LED蓝宝石晶圆做一个简单的比较。用传统的钻石划片的切割划道宽度通常为50微米(300微米芯片间距),这样每片晶圆上大约有22,500粒芯片。传统钻石划片的成品率通常为百分之九十,即每片晶圆上可用的芯片数为20,250。
采用紫外激光划片,划道宽度可以减少到20微米(270微米芯片间距),这样每片晶圆上芯片数量增加到27,800左右(增了百分之二十三)。随着成品率增加,这种方式得到的可用芯片数约为27,500,这样每片晶圆的可用芯片数总共增加了百分之三十五。
自1996年以来,JPSA一直采用266nm的DPSS激光器对蓝光LED蓝宝石晶圆的氮化镓正面进行划片,正切划片速度可达150 mm/s,这样每小时可加工大约15片晶圆(标准的2英寸直径晶圆,芯片尺寸350× 350微米)。这种方式的产量高,对LED性能的影响小,允许晶圆翘曲,比传统机械方式的划片速度要快得多。
碳化硅(SiC)划片
除了蓝宝石之外,碳化硅也可以用来作为蓝光LED薄片的外延生长基板。266nm和355nm紫外DPSS激光器(带隙能量分别为4.6 eV和3.5 eV)可用于碳化硅(带隙能量为2.8 eV)划片。因为光子能量很高,增强了耦合效率,便于进行高速划片与裂片。氮化镓与氮化铝等III族氮化物厚片也可使用紫外DPSS激光器进行划片。200到400微米厚的氮化镓或氮化铝的划片速度相比蓝宝石或碳化硅上外延薄片的划片速度要明显降低,但是其划片质量优良,裂片简便。
对于垂直结构的高功率LED,激光剥离(LLO)工艺将蓝宝石分离后,外延膜仍然与铜、铜钨、钼或硅等高导电率基板保持键合。对于硅晶圆,在300 mm/s、150 mm/s、100 mm/s的划片速度时划片深度分别为100μm、150μm和200μm。光束传输技术在一定的激光功率下保证了这些划片速度/深度,并且减少了热影响。金属基板的晶圆划片具有挑战性,因为金属的热传导率高,通常导致底焊效应。此外,当分离非常柔韧的材料时往往需要全切。JPSA已经开发了这些先进的划片技术,可以成功的刻划厚度高达200微米的基板,这对于高亮度LED产业极其重要。
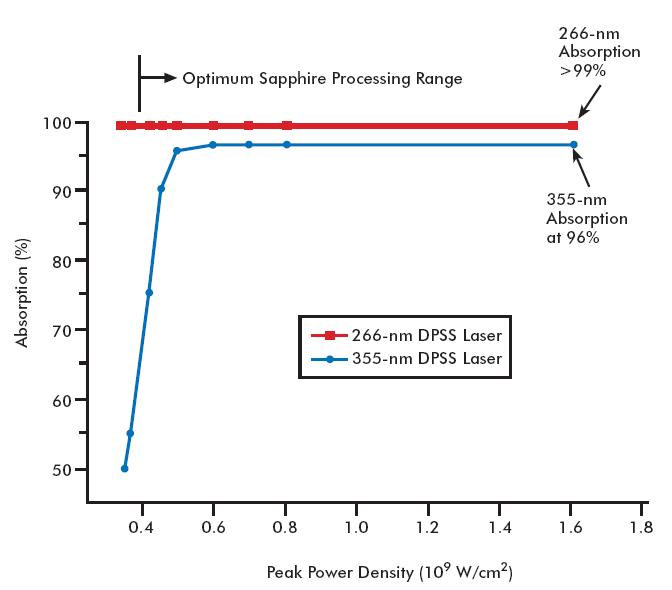
图6. LED蓝宝石对紫外激光的吸收曲线。
355nm的DPSS激光器可以从LED的蓝宝石面进行背切划片。可以使用多个检测相机从正面或背面进行晶圆对准操作,当蓝宝石有金属反射层时这一点很重要。此外,外延层没有直接接受激光辐射,可以降低光损。355nm波长的激光相对于266nm激光被蓝宝石吸收的效率要低(图6)。因此,通常需要更高的功率,从而导致更大的切口宽度和划道宽度。此外,背切划片只适用于厚度<150微米的蓝宝石晶圆,而正切划片还可以适用于厚度更大的晶圆,划片后可对晶圆研磨使其厚度变薄到裂片所需的最终厚度。
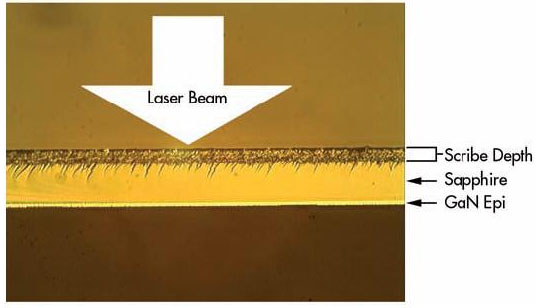
图7. 355nm二极管泵浦固体激光器对氮化镓晶圆的蓝宝石面进行背切划片的截面图。
JPSA通过持续研发背切划片的激光吸收增强等新技术,实现了划片速度高达150mm/s的高产量背切划片,无碎片并且不损坏外延层(图7)。
III-V族半导体晶圆划片
使用紫外DPSS激光器还可以将砷化镓(GaAs)、磷化铟(InP)、磷化镓(GaP)晶圆的易碎化合物半导体材料进行分离,可以进行快速精确、整齐清洁的划片,切口宽度约3微米,对III-V材料无崩边(图8)。通常情况下,250微米厚的晶圆划片速度在300mm/s,并且适合裂片(图9)。III - V族晶片价格较贵,所以晶圆基板不能浪费。紫外激光划片越紧凑、越清洁、切口越窄,每片晶圆的芯片数就越多,与传统锯片切割法相比损坏的芯片数更少,成品率就越高。
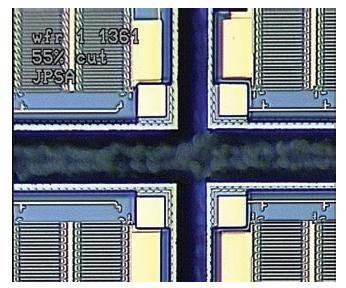
图8. 砷化镓晶片划片后的边缘清洁并且清晰。
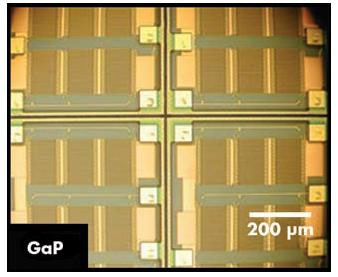
图9. 磷化镓晶圆划片速度300 mm/s,划片深度30 μm,深度足够使250 μm厚的晶圆裂片。
展望
LED技术因为追求更高的效率和更低的制造成本,其发展日新月异。这种“绿色”技术无疑具有光明的未来,但是也面临着很多挑战。
目前全球对于LED的需求急速增长,这就要求有新的激光加工工艺与技术来获得更高的生产品质,更高的成品率和产量。除了激光系统的不断发展,新的加工技术和应用,光束传输与光学系统的改进,激光光束与材料之间相互作用的新研究,这些都是要保持这个绿色技术革新能够继续前进所必须的。
设备工程师面临的挑战是要建立灵活的操作工具。自动盒式装卸功能、边缘检测功能和自动聚焦功能等选项实现了最先进的激光划片解决方案。JPSA公司持续研发激光前沿技术,以满足LED制造业的市场需求。